IC封装的材料和方法
点击:5823次 发布时间:2015-05-17 数据来源:东莞艾迪科

在定义了封装的基本结构之后,继续介绍下一级互连中的封装技术。比如,以引线框架和双列直插封装(DIP)为代表的许多传统IC封装,用于针脚插入型焊接装配。而以针栅阵列(PGA)为代表的其他形式的封装可插在插孔中。还有一些,如以四方扁平封装(QFP)、无引脚引线框架封装和面积接近芯片面积的四方扁平无引脚封装(QFN)为代表的柔性引脚引线框架封装,则用于表面贴装技术(图1)。

图1. IC封装有着许多种尺寸、形状和引脚数量,以满足IC和系统不同的要求。
除了以QFP和QFN为代表的四周引脚封装,还有平面阵列封装。由于平面阵列封装本身具有良好的处理高I/O数和管理I/O端分布的能力,而同时又不会降低性能,所以用平面阵列的方法来形成IC封装的I/O已经变得越来越普及。球栅阵列封装(BGA)就是平面阵列封装的典型代表。正是由于这些优势,BGA的身影出现在了从微小尺寸芯片、圆片级封装到拥有数千个I/O的大尺寸IC的各个应用领域。由于已经有了制造有机层压基板的划算的大型制造设备,所以BGA封装通常采用这种基板。BGA封装还经常被用于不断成长的叠层芯片、多芯片和叠层封装结构之中。多芯片封装被认为是一种有可能替代芯片上系统(SOC)的可行的解决方案。现在还日益涌现出基于阶梯形封装和双面互连概念的新的封装形式(图2)。
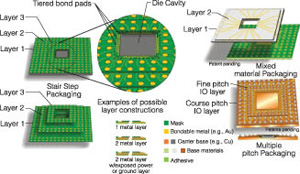
图2. 不同寻常的BGA封装结构的示意图(由SiliconPipe公司提供)。
1 2 3